未来五年扇出型封装将逐渐走向多晶片系统级封装(Multi-die System-in-Package),同时扇出型封装亦朝向高密度(High I/O Density)-亦即细线宽线距发展,并併随朝向更大的扇出型
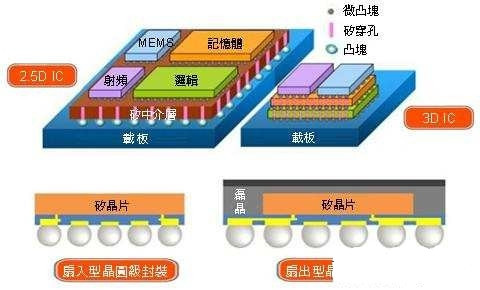
扇出型晶圆级封装将成先进封装技术发展要点_
480x290 - 41KB - JPEG

扇出型晶圆级封装将成先进封装技术发展要点
480x290 - 35KB - JPEG
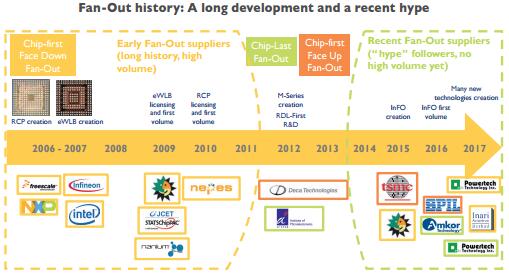
《扇出型封装技术及市场趋势-2016版》
509x274 - 26KB - JPEG
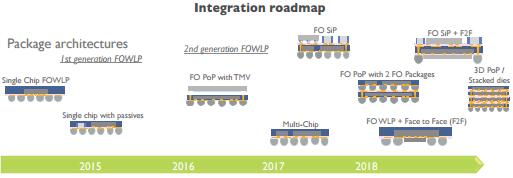
《扇出型封装技术及市场趋势-2016版》
513x178 - 13KB - JPEG

打印_扇出型晶圆级封装将成先进封装技术发展
480x290 - 20KB - JPEG

扇出型晶圆级封装将成先进封装技术发展要点
480x290 - 33KB - JPEG

期投资23.3亿 华进半导体晶圆级扇出型封装项
361x240 - 31KB - JPEG

传iPhone7将用新型天线技术 大白带问题有望解
600x494 - 64KB - JPEG

半导体科技.先进封装与测试杂志 - 未来移动通
650x294 - 55KB - JPEG

用于超薄扇出堆叠型封装的激光剥离
315x575 - 32KB - JPEG
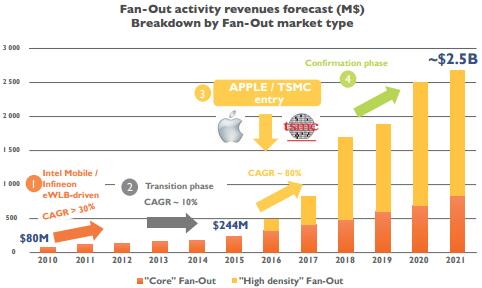
《扇出型封装技术及市场趋势-2016版》
482x288 - 21KB - JPEG

扇出型封装技术的发展历史及其优势详解-电子
552x312 - 183KB - PNG

《扇出型封装设备和材料-2017版》
636x333 - 15KB - JPEG

《扇出型封装设备和材料-2017版》
597x395 - 18KB - JPEG

数字化智能时代的芯片封装技术
523x297 - 17KB - JPEG