半导体工业需要将薄晶圆减薄至100μm以下。超薄薄晶圆具有柔性和易碎性、容易翘曲和起伏等特点,因此通常先将器件晶圆用临时键合材料键合到较厚的载体上,经过背部减

VG 已在全球范围建立超过 1100 个EVG 晶圆键
2000x1678 - 680KB - JPEG
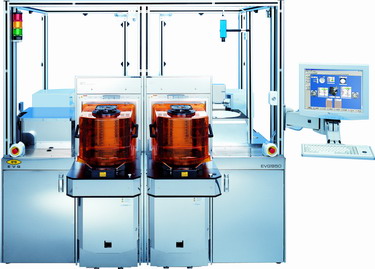
上海新傲科技公司继续订购EVG晶圆片键合机
375x269 - 31KB - JPEG

EVG发布新一代融化晶圆键合平台GEMINI FB
400x283 - 36KB - JPEG

EVG集团300毫米聚合体自动晶圆键合系统销量
571x382 - 215KB - PNG

应用于3-D互连的对准晶圆键合技术[EDA\/IC设
250x250 - 30KB - JPEG

【EVG晶圆键合机501\/510\/520\/540系列】价格
289x354 - 20KB - JPEG

SUSS MicroTec推出CB系列MEMS晶圆键合设
550x448 - 32KB - JPEG

【无需光刻胶 BOROFLOAT 33 晶圆键合 晶体
352x264 - 25KB - JPEG

应用于3-D互连的对准晶圆键合技术[EDA\/IC设
400x237 - 45KB - JPEG

晶圆与晶圆键合对准机
183x247 - 39KB - JPEG

晶圆键合:选择合适的工艺来制造大功率垂直LE
295x321 - 36KB - JPEG

玻璃加工-低膨胀石英 BK7 晶圆级封装 晶圆键合
400x300 - 30KB - JPEG
近红外相机用于芯片检测
565x490 - 42KB - JPEG

微电子所在传感器晶圆级键合封装技术研究中取
499x267 - 27KB - JPEG

【晶圆解键合机-首选EVG805DB】价格,厂家,
811x461 - 62KB - JPEG